KRi 射频离子源 RFICP 系列阅读数: 8452

KRi 射频离子源 RFICP 系列
上海伯东美国 KRi 射频离子源 RFICP 系列, 无需灯丝提供高能量, 低浓度的离子束, 通过栅极控制离子束的能量和方向, 单次工艺时间更长! 射频源 RFICP 系列提供完整的系列, 包含离子源本体, 电子供应器, 中和器, 自动控制器等. 射频离子源适合多层膜的制备, 离子溅镀镀膜和离子蚀刻, 改善靶材的致密性, 光透射, 均匀性, 附着力等.
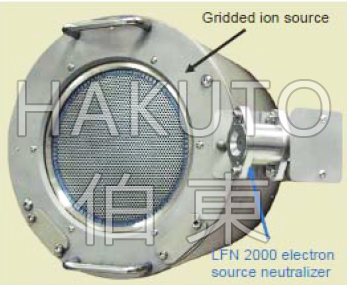
射频离子源 RFICP 系列技术参数:
|
型号 |
|||||
|
Discharge 阳极 |
RF 射频 |
RF 射频 |
RF 射频 |
RF 射频 |
RF 射频 |
|
离子束流 |
>100 mA |
>350 mA |
>600 mA |
>800 mA |
>1500 mA |
|
离子动能 |
100-1200 V |
100-1200 V |
100-1200 V |
100-1200 V |
100-1200 V |
|
栅极直径 |
4 cm Φ |
10 cm Φ |
14 cm Φ |
22 cm Φ |
38 cm Φ |
|
离子束 |
聚焦, 平行, 散射 |
|
|||
|
流量 |
3-10 sccm |
5-30 sccm |
5-30 sccm |
10-40 sccm |
15-50 sccm |
|
通气 |
Ar, Kr, Xe, O2, N2, H2, 其他 |
||||
|
典型压力 |
< 0.5m Torr |
< 0.5m Torr |
< 0.5m Torr |
< 0.5m Torr |
< 0.5m Torr |
|
长度 |
12.7 cm |
23.5 cm |
24.6 cm |
30 cm |
39 cm |
|
直径 |
13.5 cm |
19.1 cm |
24.6 cm |
41 cm |
59 cm |
|
中和器 |
LFN 2000 or RFN |
||||
射频离子源 RFICP 系列应用:
离子辅助镀膜 IBAD ( Ion beam assisted deposition in thermal & e-beam evaporation )
离子清洗 PC (In-situ preclean in sputtering & evaporation )
表面改性, 激活 SM (Surface modification and activation )
离子蚀刻 IBE (Ion beam etching of surface features in any material)
离子溅镀 IBSD (Ion beam sputter deposition of single and multilayer structures)

上海伯东美国考夫曼 KRi 大口径射频离子源 RFICP 220, RFICP 380 成功应用于 12英寸和 8英寸离子束刻蚀机, 作为蚀刻机的核心部件, KRI 射频离子源提供大尺寸, 高能量, 低浓度的离子束, 接受客户定制, 单次工艺时间更长, 满足各种材料刻蚀需求!

1978 年 Dr. Kaufman 博士在美国创立 Kaufman & Robinson, Inc 公司, 研发生产考夫曼离子源, 霍尔离子源和射频离子源. 美国考夫曼离子源历经 40 年改良及发展已取得多项成果. 离子源广泛用于离子清洗 PC, 离子蚀刻 IBE, 辅助镀膜 IBAD, 离子溅射镀膜 IBSD 领域, 上海伯东是美国考夫曼离子源中国总代理.
若您需要进一步的了解 KRi 射频离子源, 请参考以下联络方式
上海伯东: 叶小姐 台湾伯东: 王小姐
T: +86-21-5046-3511 ext 107 T: +886-3-567-9508 ext 161
F: +86-21-5046-1490 F: +886-3-567-0049
M: +86 1391-883-7267 M: +886-939-653-958
上海伯东版权所有, 翻拷必究!

 上海
上海